本文内容由半导体行业观察综合自nis。
今天,拜登-哈里斯政府宣布了提高美国先进封装能力的愿景,先进封装是制造最先进半导体的关键技术。美国商务部负责标准与技术的副部长兼国家标准与技术研究所(NIST)主任Laurie E.Locascio在摩根州立大学发表讲话时阐述了美国将如何从商务部CHIPS for America计划的制造激励和研究中受益和发展努力。
特别是,国家先进封装制造计划的约30亿美元资金将用于推动美国在先进封装领域的领导地位。该计划的初始资助机会预计将于2024年初公布。支持创新并让美国保持在新研究的前沿是总统投资美国议程的重要组成部分。
“对国内封装能力和研发进行大量投资对于在美国创建繁荣的半导体生态系统至关重要。我们需要确保我们的研究实验室能够发明新的前沿芯片架构,为每种最终用途应用而设计,大规模制造并采用最先进的技术进行封装。这种先进封装的新愿景将使我们能够实施拜登总统的投资美国议程,并使我们的国家成为尖端半导体制造领域的领导者。”商务部长吉娜·雷蒙多(Gina Raimondo)表示。
“在十年内,我们预计美国将制造和封装世界上最先进的芯片,”NIST主任Laurie E.Locascio说道。“这意味着既要建立一个能够自我维持、盈利且环保的大批量先进封装行业,又要进行研究以加速新包装方法进入市场。”
为了概述这一愿景,CHIPS for America发布了“国家先进封装制造计划愿景”(NAPMP),其中详细介绍了两党CHIPS和科学法案创建的先进封装计划的愿景、使命和目标。
NAPMP是四个CHIPS for America研发计划之一,这些计划共同建立了所需的创新生态系统,以确保美国半导体制造设施(包括由CHIPS法案资助的设施)生产世界上最复杂和最先进的技术。
先进封装是一种尖端的设计和制造方法,它将具有多种功能的多个芯片放置在一个紧密互连的二维或三维“封装”中。这种设计范例可以帮助该行业实现最先进半导体所需的更密集、更小的尺寸。先进封装需要采用跨学科方法,将芯片设计师、材料科学家、工艺和机械工程师、测量科学家等聚集在一起。它还需要获得先进封装设施等资源。目前,美国的传统和先进封装产能均有限。
在美国发展这些先进的封装能力是进一步增强该国技术领先地位和经济安全的关键一步。因此,CHIPS for America研发计划将支持美国先进封装技术的开发,这些技术可以部署到制造工厂,包括CHIPS制造激励措施的接受者。
今天宣布的这项约30亿美元的计划将专门用于各种活动,包括建立先进的封装试点设施,用于验证新技术并将其转移给美国制造商;劳动力培训计划,以确保新流程和工具配备有能力的人员;以及为以下项目提供资金:
- 材料和基材,
- 设备、工具和流程,
- 电力输送和热管理,
- 光子学和连接器,
- 小芯片生态系统,以及
- 测试、修复、安全性、互操作性和可靠性的协同设计。
今天发布的文件的部分目的是在未来的融资机会之前向包装界提供NAPMP愿景的更多细节。该部门预计将于2024年宣布NAPMP的第一个融资机会(针对材料和基材)。随后将公布有关投资领域(包括包装试点设施)的其他公告。
“国家先进封装制造计划将与美国国家半导体技术中心(NSTC)等所有CHIPS研发计划以及我们的联邦机构合作伙伴密切合作,”CHIPS研究与开发总监Lora Weiss表示。“这些强大的研究项目将共同支持如此先进的技术创新,以至于半导体制造商将选择投资美国和我们本土的封装能力。”
附:美国先进封装愿景
据NIST在白皮书中所说,美国的先进封装愿景包括:
使成功的先进封装开发工作得到验证并大规模转移到美国制造。
开发能够进行大批量和定制制造的封装平台。
创建基于异构chiplet技术的先进封装生态系统,以促进芯片的广泛和易于使用
技术开发。
加强先进封装劳动力发展工作,以维持国内生态系统。
而为了实现这些目标,美国相关机构设定了六个最优先的研究投资领域及其相互依赖性如下图所示:
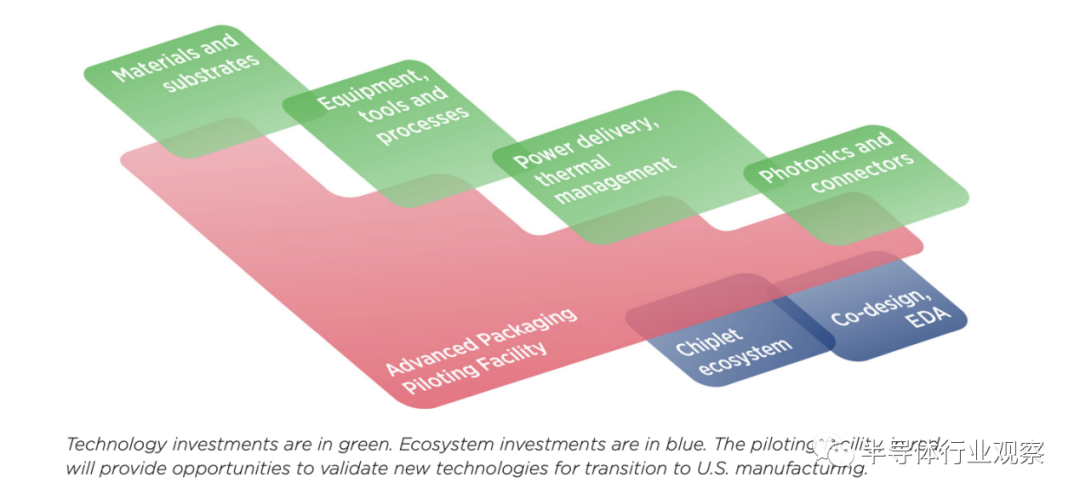
美国方面认为,封装是复杂且跨学科的,需要示意性所示区域的相互作用。这些领域之间的交叉凸显了相互依赖性;他们的无缝互动对于战略和运营上的成功至关重要。NAPMP将积极推动这些领域和业务互动的进步。具体关注的领域如下所示:
1、材料和基板是构建先进封装的平台。新基板的关键要求包括多层精细布线和通孔间距、低翘曲、大面积以及集成有源和无源元件的能力。这些基板可以基于硅、玻璃或有机材料,并且可以包括扇出晶圆级工艺。
2、需要先进的设备、工具和工艺,以便对基板进行图案化并将小芯片可靠地组装在这些基板上。CMOS设备和工艺将进行调整处理与不同类型基板兼容的芯片和晶圆。
3、先进封装组件的电力传输和热管理。先进封装对功率密度和散热方面的要求很高。先进封装要想取得成功,就必须解决电力输送和高效热管理方面的进步。他们需要与所使用的基板和组装工艺兼容的创新材料和解决方案。这些活动将需要新的热材料以及采用先进基板和异构集成的新颖电路拓扑。
4、与外界通信的光子学和连接器。管理长途通信需要低错误率光子学和高密度、高速和低损耗的有源连接器,并且需要新颖且紧凑的解决方案。重点将放在可靠且可制造的集成连接器上,包括计算能力、数据预处理、安全性以及易于安装到封装组件上。
5、开发chiplet生态系统。小芯片是指小型、部分功能的半导体芯片,当它们以紧密的间距且彼此靠近地组装时,就会形成一个功能强大的子系统。将开发小芯片发现方法,以确保这些小芯片的高水平可重用性、设计和仓储。
6、使用自动化工具共同设计这些多芯片子系统。这些将适用于先进封装,同时考虑内置测试和修复、安全性、互操作性和可靠性,并具有详细了解用于组装的基板和工艺,包括热和电源管理解决方案。
除此以外,NAPMP还打算将劳动力教育和培训纳入NAPMP的所有工作中,利用每个投资领域和APPF内的实习、合作社、勤工俭学计划、研讨会、实践体验式学习以及其他教育进步活动。NAPMP打算资助包含强有力的劳动力发展计划的项目,这些计划强调教育进步和专业发展。
NAPMP与所有CHIPS研发项目密切合作,以实现CHIPS研发办公室的集体项目目标,即通过建立、连接和提供对国内工具、资源、工人和设施的访问来加速基础半导体技术的开发和商业部署。
例如,NSTC可能会管理APPF活动的物理整合。与计量部门的合作计划可以开发工具和制造测试工具来验证包装产品的性能以及标准开发因为这些新的封装方法需要实现其广泛采用。
NAPMP正在与其他政府机构密切合作,共同目标是提高美国在先进组装、封装和测试方面的能力和能力,特别关注可以转移到NSTC和NAPMP设施中的转型异构集成技术。
根据计划,NAPMP预计于2024年初发布第一个资助机会。第一个资助机会的主题将是材料和基材。