本文来自AI芯天下,作者/方文三。
作为社会的发展趋势,万物智联意味着未来将有更庞杂的终端体系、更多元化的应用场景以及更多样化的交互方式。
未来终端电子需要整合的功能将越来越多,如何在体积、功耗等条件限制下实现多功能集成也将成为AIoT行业绕不开的痛点。

SiP是SoC技术在纳米时代的裂变
与SoC不同的是,SiP是从封装的角度出发,以并排或叠加的封装方式,将多种功能芯片,包括处理器、存储器等集成在一个封装内,从而实现一个基本完整的功能。
理论上要比SiP更具有优势,但在实际封装上,各模块无法做到性能的全面最优。
这就不得不在性能上进行妥协,这使得在设计上无法灵活自如。此外,较低的良率也是SOC无法大规模应用的原因。
随着物联网应用规模落地,越来越多物联网智能终端需要更加极致的设计和多功能的整合,通过SiP技术达到模组芯片化将会日益受到关注。
不过,伴随着NB-IoT应用规模的进一步持续扩大,新应用、新场景、新需求不断推陈出新,各家NB-IoT模组方案也逐渐演进至全新发展阶段。
随着物联网应用规模落地,越来越多物联网智能终端需要更加极致的设计和多功能的整合,通过SiP技术达到模组芯片化将会日益受到关注。
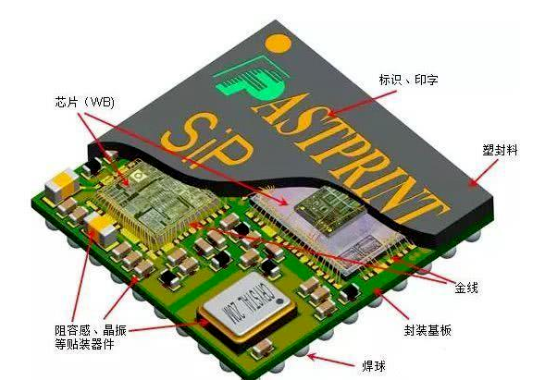
SiP芯片在物联网应用全面开花
随着智能终端的普及,人们对于消费电子产品的要求也愈发向着体积小、重量轻、功能全以及低功耗方向发展。
为了能在更小的空间内构建功能更加丰富、针对行业用户进行深度优化的芯片系统,系统级IC封装(SiP,System in Package)成为了半导体行业内的新趋势。
当前包括奉加微在内的诸多物联网通信芯片原厂纷纷开始发力,推出功能丰富的SiP芯片产品。
对于物联网产业链而言,SiP集成方案在成为物联网下游终端客户明智之选的同时,自然也成为了物联网上游通信芯片原厂的发力重点。
对于物联网下游终端客户而言,SiP技术减少了芯片的重复封装,降低了布局与排线难度,也进一步缩短了物联网产品的研发周期,有助于行业用户研发的产品更快实现商业化落地。
苹果就是SiP技术的坚定拥护者,比如iPhone7 Plus中就采用了约15处不同类型的SiP封装技术,以便在智能手机功能不断丰富以及高性能的过程中仍保持其轻薄化。

SIP的小型化优势
①灵活性高,可依照客户或产品的需求进行定制化。
②降低生产及制造成本,如PCB层数降低50%,面积减小50%以上,PCB贴片点位减少及贴片工艺要求降低带来的成本节约。
③更高的可靠性及更低的故障率,一个SIP封装减少了数百个焊点及潜在故障点,同时使SOC免受环境条件的影响;
④大幅降低测试及调试难度,无需专业设备即可上手使用;
⑤大幅降低使用复杂度及开发难度,甚至SIP供应商还可以提供系统软件包服务,进而缩短开发周期及降低开发成本;
⑥帮助Tier 1将设计精力转移至系统功能,进而为客户创造更大的价值。
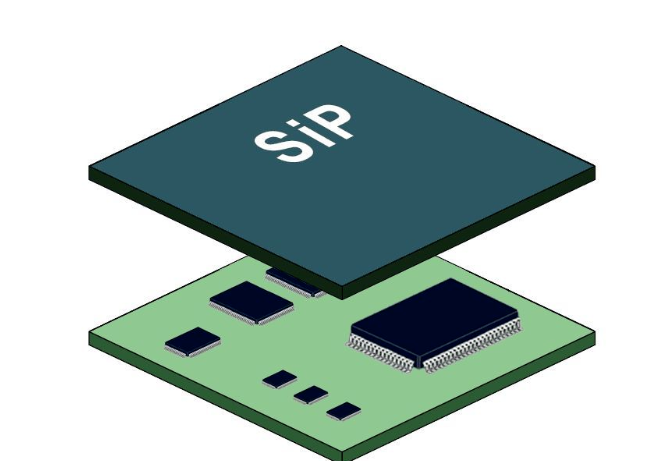
物联网下的新目标与预期值
近日,工信部联合国家网信办、科技部等八部委印发《物联网新型基础设施建设三年行动计划(2021-2023年)》也印证了这个观点。
行动计划提出,到2023年底,在国内主要城市初步建成物联网新型基础设施。
《行动计划》同时还讲到,到2023年底的一系列量化目标:
推动10家物联网企业成长为产值过百亿、能带动中小企业融通发展的龙头企业;
物联网连接数突破20亿;完善物联网标准体系,完成40项以上国家标准或行业标准制修订。

据相关统计显示,未来十年,联网的设备数量会增长20倍,这将带来高达7万亿美金的新增市场,随之而来的是大量的芯片机会。
市场研究机构IC Insights发布的报告中指出,受益于市场的强劲需求,今年整体芯片市场的收入预计将提高24%,并突破史上首个5000亿美元大关。
预测期(2020-2025年)内芯片市场的年复合增长率将达到10.7%;到2023年,全球芯片市场收入将突破6000亿美元。
当前,中国作为全球最大的物联网市场,IDC最新预测数据显示,中国物联网企业级市场规模将在2026年达到2940亿美元,复合增长率(CAGR)13.2%。
随着物联网的快速兴起,毫无疑问系统级SiP芯片也将迎来快速发展机遇。

结尾:
封装已经处于大爆发阶段,封装形式层出不穷。同时,市场竞争局面将越来越复杂,研发周期变得越来越快,需要产业链厂商通力合作来应对其中的挑战。
部分资料参考:半导体行业观察:《系统级SiP芯片,物联网下一个竞争高地》,半导体工程师:《SIP封装工艺流程》,联想创投:《物联网时代的芯片产业新趋势》

