本文来自微信公众号“半导体行业观察”,内容由半导体行业观察(ID:icbank)编译自yole,谢谢。
据Yole预测,先进封装(AP:Advanced Packaging)市场在2022年价值443亿美元,预计从2022年到2028年将以10.6%的复合年增长率(CAGR)增长至786亿美元。相比之下,传统封装市场预计从2022年到2028年的复合年增长率将放缓至3.2%,达到575亿美元。总体而言,封装市场预计将以6.9%的复合年增长率增长,达到1360亿美元。
到2022年,AP市场约占整个集成电路(IC)封装市场的48%,并且由于各种大趋势,其份额正在稳步增加。在AP市场中,包括FCBGA和FCCSP在内的倒装芯片平台在2022年占据了51%的市场份额。预计2022年至2028年收入复合年增长率最高的细分市场是ED、2.5D/3D和倒装芯片,增长率分别为30%、19%和8.5%。
到2022年,移动和消费者占整个AP市场的70%,预计2022年至2028年的复合年增长率为7%,到2028年占AP收入的61%。电信和基础设施部分增长最快,具有估计收入增长率约为17%,预计到2028年将占AP市场的27%。汽车和运输将占市场的9%,而医疗、工业和航空航天/国防等其他领域将占3%。
尽管传统封装目前主导晶圆生产,到2022年将占总产量的近73%,但AP市场的份额正在逐渐增加。AP晶圆的市场份额预计将从2022年的约27%增长到2028年的32%。按单位计算,传统封装占据超过94%的市场份额,但AP在2022年到2028年的出货量预计将以约6%的复合年增长率增长,这意味着到2028年达到1010亿单元出货量。

超越摩尔定律的创新:小芯片和混合键合开辟新领域
先进封装已成为半导体创新、增强功能、性能和成本效益的关键。台积电、英特尔和三星等大公司正在采用小芯片和异构集成策略,利用AP技术以及前端扩展工作。
chiplet方法将SoC芯片划分为多个芯片,仅缩放具有先进技术节点的芯片,并使用2.5D或3D封装将它们集成。这提高了产量并降低了成本。混合键合(HB:Hybrid Bonding)是另一个重要趋势,可实现金属-金属和氧化物-氧化物面对面堆叠,且凸点间距小于10µm。它用于CIS和3D NAND堆叠等应用的晶圆到晶圆混合键合,以及用于PC、HPC和数据中心的逻辑上内存堆叠3D IC中的3D SoC的持续开发。
台积电凭借其CoWoS生产和多样化产品组合(包括3D SoIC、InFO_SoW和CoWoS变体)在高端先进封装领域处于领先地位。英特尔在2022年大力投资先进封装,但宏观经济因素影响了其2023年的核心业务。因此,我们预计台积电今年在先进封装方面的投资将超过英特尔。三星为HBM和3DS产品、扇出面板级封装和硅中介层提供先进封装解决方案,从而实现高端性能产品。
与传统封装相比,先进封装需要不同的设备、材料和工艺,例如新的基板材料、光刻工艺、激光钻孔、CMP和KGD测试。AP参与者进行了大量投资来开发和引入这些进步。与先进封装的异构集成推动了半导体创新,提高了整体系统性能,同时降低了成本。
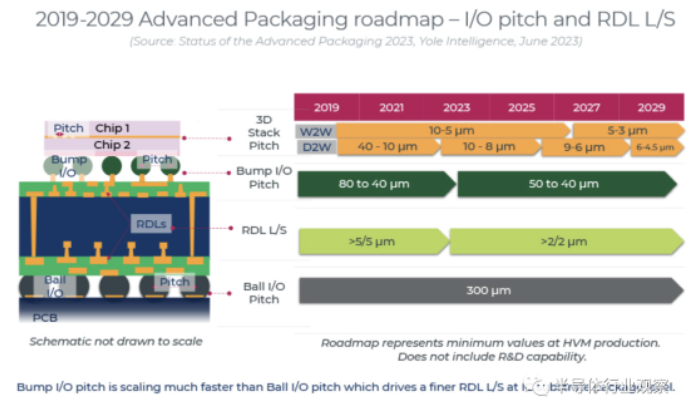
半导体供应链:新的地缘政治战场
由于芯片短缺和地缘政治紧张局势,包括先进封装在内的半导体价值链受到关注。各国政府正在投资了解和加强国内生态系统。中美之间的冲突扰乱了供应链,影响了半导体公司获得芯片和设备。先进封装(AP)被视为后摩尔定律时代的关键,预计到2028年AP市场将达到780亿美元。然而,贸易紧张局势导致新的价值链和生产搬迁,使供应链多样化,但有风险中国产能置换。七大厂商主导AP,OSAT贡献了65.1%AP晶圆。OSAT扩展了测试专业知识,而传统测试参与者则投资于封装。随着来自不同模型的参与者进入封装,蚕食OSAT,业界看到了范式转变。基板供应一直紧张,影响材料可用性并导致交货时间延长和价格上涨。需求减少和产能扩张可能有助于缓解短缺。基板供应商投资于产能扩张但面临时间限制,导致未来2至3年持续存在供应问题。


